프로텍, ASE에 AI 반도체향 '레이저 본더' 공급…HBM 시장도 모색
차세대 '레이저 본더'로 글로벌 OSAT 시장 공략
비메모리 공략 후 HBM 시장 도전
글로벌 증설 수혜 기대…실적 성장 전망

프로텍 본사. (사진=프로텍 홈페이지)
*재판매 및 DB 금지
[서울=뉴시스] 배요한 기자 = 코스닥 상장사 프로텍이 차세대 레이저 본딩 장비를 글로벌 최대 반도체 후공정(OSAT) 업체인 에이에스이(ASE)사에 공급한 것으로 확인됐다. 프로텍은 비메모리 패키지 시장을 기반으로 래퍼런스를 확보한 뒤, 고대역폭메모리(HBM) 시장까지 영역을 넓힌다는 전략이다.
29일 증권업계에 따르면 프로텍은 올해 초 ASE에 인공지능(AI) 반도체용 레이저 본더를 납품했다. 지난해 데모 장비를 공급한 데 이어, 올해부터 본격적인 수주가 시작된 셈이다.
프로텍은 2021년 레이저 본더 개발에 착수해 2023년 3월 앰코테크놀로지코리아와 공동으로 AI 반도체용 장비를 개발했다. 이후 테스트와 양산 준비를 거쳐 지난해 말부터 양산에 돌입했다.
프로텍 관계자는 "글로벌 고객사향 신규 레이저 본더 장비 수주가 발생한 것은 사실"이라며 "이번 래퍼런스를 기반으로 다른 후공정 업체로도 장비 공급을 확대할 계획"이라고 말했다.
해당 장비는 2.5D 및 3D 패키징 등 고급 반도체 패키징 기술에 적용된다. 2.5D 패키징은 얇고 넓은 중간기판(인터포저) 위에 여러 칩을 배치해 빠른 데이터 전송과 낮은 전력 소모를 구현하며, 3D 패키징은 칩을 수직으로 적층해 공간 절약과 초고속 데이터 전송을 가능케 한다.
프로텍의 레이저 본더는 기존 열압착(TC) 본더 대비 진화한 장비로, 상부 가열 대신 인쇄회로기판(PCB) 하부에서 적외선(IR) 레이저를 쏘는 방식을 채택했다. 레이저 열원 특성으로 2~3초 만에 본딩 공정을 완료할 수 있어, 열 노출 시간을 줄이고 PCB 휨 현상을 최소화할 수 있다. 이를 통해 칩 손상 위험을 낮추고 생산성을 높일 수 있다는 강점이 있다.
ASE는 반도체 패키징 및 테스트 분야 세계 1위 기업으로, 이번 수주는 프로텍의 글로벌 OSAT 시장 내 입지를 강화하는 계기가 될 전망이다.
프로텍은 우선 인터포저와 PCB를 연결하는 비메모리 본딩 시장을 집중 공략한 뒤, 향후 한미반도체가 독점하고 있는 HBM 본딩 장비 시장으로 포트폴리오를 확장할 계획이다.
현재 HBM 본딩 공정에는 주로 TC 본더 기술이 활용되고 있지만, 최근 하이브리드 본딩 등 새로운 기술이 등장하고 있다. HBM은 D램 칩을 수직으로 적층할수록 용량이 커지지만, 칩 두께가 얇아지면서 압력과 웨이퍼 휨 현상이 심화되는 문제가 있다. 이에 따라 HBM 완성도와 수율을 높이기 위해 차세대 본딩 기술이 필요한 상황이다.
박장욱 대신증권 연구원은 "반도체 미세화와 적층이라는 공정 트렌드를 고려하면 레이저 기반 기술 장비의 수요가 점차 커질 것"이라고 내다봤다.
회사 관계자는 "메모리 시장은 기술 변화 속도가 빠른 만큼 시간적 제약이 있다"면서도 "우선 비메모리 시장을 집중 공략한 뒤 메모리 시장 진출에도 나설 예정"이라고 말했다.
임소정 유진투자증권 연구원은 프로텍에 대해 "하이엔드 패키지 장비 수요가 견조한 가운데, 중국 수요까지 더해져 올해 고른 매출 포트폴리오가 형성될 것"이라며 "글로벌 메이저 OSAT 업체들의 증설이 본격화되는 올해부터 프로텍이 가장 큰 수혜를 볼 것"이라고 내다봤다.
금융정보업체 에프앤가이드에 따르면 올해 프로텍의 매출은 전년 대비 3.58% 증가한 1764억원, 영업이익은 92.5% 급증한 258억원을 기록할 것으로 예상됐다.
한편 프로텍은 디스펜서, 다이본더 등 다양한 반도체 패키지 공정 장비와 부품을 생산하는 전문 제조기업이다. 주요 고객사로 삼성전자, SK하이닉스, 앰코테크놀로지 등을 확보하고 있으며, 발광다이오드(LED) 및 모바일 분야에서는 오스람(OSRAM), LG전자 등을 고객사로 두고 있다.
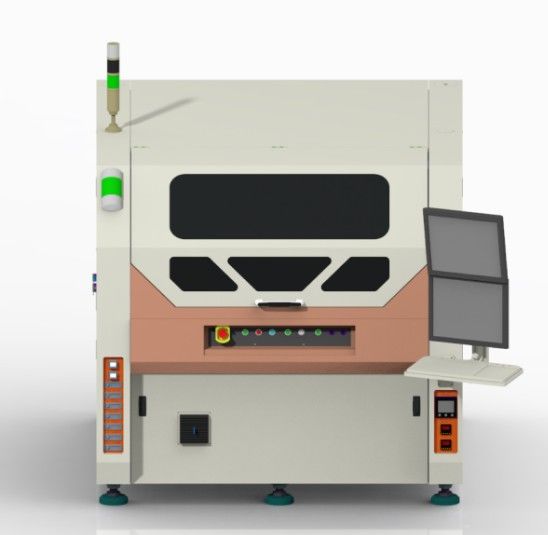
프로텍 레이저 보조 장비(사진=프로텍 홈페이지) *재판매 및 DB 금지
◎공감언론 뉴시스 [email protected]
Copyright © NEWSIS.COM, 무단 전재 및 재배포 금지






















































































































